Ähnlich erlauben TSVs die Integration von heterogenen Kontakten, die unterschiedliche Prozessknoten und unterschiedliche Fertigungstechnologien verwenden. TSVs erhöhen deutlich die Bandbreite zwischen dem Logikchip und dem Speicher insbesondere bei breiten Speicherschnittstellen, was mit herkömmlichen Bond-Wires nicht erreicht werden kann. Allerdings gibt es Bedenken hinsichtlich der Zuverlässigkeit von TSVs. Es wurde bewiesen, dass thermische Zyklen, wie zum Beispiel Glühen, einen mechanischen Ausfall in TSVs induzieren können. Die Unterschiede in den thermischen Ausdehnungskoeffizienten zwischen Cu und dem Si-Wafer führen zu einer beträchtlichen mechanischen Belastung, die einen Einfluss auf die Geräteleistung hat. Cu-Extrusionen, welche durch thermische Behandlungen induziert werden, können dazu führen, dass sowohl TSVs als auch benachbarte Verbindungsstrukturen ausfallen.
TESCAN bietet der Halbleiter- und Verpackungsindustrie ein breites Spektrum an Systemen und Detektoren, um analytische Techniken zur Untersuchung von Eigenspannungen und Cu-Extrusionen in TSVs zu implementieren. Unser Angebot an Hochleistungs-REM (MIRA3, MAIA3) ermöglicht eine hochauflösende Bildgebung der TSV-Extrusionen für eine Inspektion des Querschnitts. Dual-Beam-Systeme ermöglichen die Ermittlung von Fehlstellen und eine anschließende lokale Inspektion und Charakterisierung dieser mit einem einzigen Instrument. TESCAN Xe Plasma FIB-REM Systeme (FERA3 und XEIA3) bieten eine wesentliche Durchsatzsteigerung für die Analyse in TSVs.
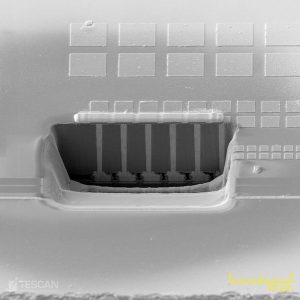
Großer Querschliff eines 3D-IC mit 5 Cu-TSVs und Cu-Bump-Kontakt in Silizium. Der Schnitt wurde in weniger als einer Stunde unter Verwendung von Xe-Plasma-FIB hergestellt.
- TSVs weisen Längen von 50 bis 100 μm auf und haben einen Durchmesser von 15 bis 30 μm. TSVs sind üblicherweise in Arrays, welche im Abstand von über 500 μm liegen können, angeordnet. Eine Querschnittsabbbildung dieser Strukturen mit herkömmlichen Ga-Ionenquellen kann herausfordernd sein.
- Große Querschnitte machen es möglich, Hohlräume, Delamination, Risse und andere Defekte in TSVs zu finden und zu untersuchen.
- EDX und EBSD Analysen können implementiert werden, die Cu-Mikrostruktur TSVs zu studieren.
- Xe-Plasma-FIB induziert weniger Schäden im Vergleich zu Ga (Amorphisierung des Probenmaterials, Fremdatomimplementierung), was ein Vorteil für die EBSD- und EDX-Analyse ist.
- BSE cross-sectional view of 2.5D stacked-die showing two Cu TSVs passing through silicon interposer in order to connect upper metal layers to additional backside metal layers
- Cross-section of 2.5D stacked-die showing a solder ball and two TSVs
- Magnified image of a Cu TSV showing the solder bump, passivation layer, mold compound and liner oxide layer
- Upper part of a TSV imaged with the SE detector
- Bottom part of a TSV imaged with the BSE detector for grain contrast
- EBSD maps of a set of 4 × 50 μm copper TSVs polished by plasma FIB showing an overlay of a SE image with the IPF orientation maps. Image taken from T.Hrncir, et.al. ISTFA 2014, p. 136